AI·전장 시대 주목받는 차세대 패키지 기판
공간효율·전송속도 높여 첨단 반도체 지원
대만·일본 잡은 시장…韓, 투자 공세 시작
[이데일리 김응열 기자]
글로벌 산업계의 핵심으로 떠오른 반도체 뉴스가 쏟아지고 있습니다. 우리 곁의 가전제품은 나날이 똑똑해지고 어려운 기술 용어도 뉴스에 속속 등장하고 있습니다. 봐도 봐도 어렵고 알다가도 모르겠는 전자 산업, 그 속 이야기를 알기 쉽게 ‘톡(Talk)’해드립니다. <편집자주>
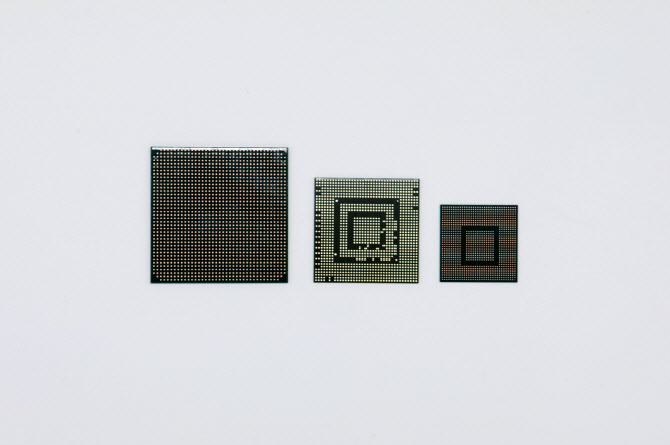 | | LG이노텍의 FC-BGA 기판 제품. (사진=LG이노텍) |
|
인공지능(AI) 열풍의 수혜를 보는 건 고대역폭메모리(HBM) 같은 AI향 메모리만이 아닙니다. 고성능 반도체를 지원할 차세대 반도체 기판 ‘플립칩-볼그리드어레이(FC-BGA)’도 덩달아 뜨고 있습니다. 대만과 일본, 한국 기업 등이 이 시장을 공략하기 위해 경쟁적으로 뛰어들고 있죠.
FC-BGA가 무엇이길래 앞다퉈 시장에 뛰어드는 걸까요. FC-BGA는 인쇄회로기판 중 가장 높은 기술력을 요구하는 고부가기판 제품입니다. 반도체 집적회로(IC)칩을 전자기기 등의 메인보드에 장착해 연결하고 전기 신호를 중재해주는 게 패키지 기판인데요, FC-BGA는 IC칩을 뒤집고(FlipChip·플립칩) 구 형태로 나란히 배열된 부품(BallGridArray·볼그리드어레이)을 통해 연결하는 방식입니다.
 | | 반도체 패키지 기판의 와이어 본딩 방식과 플립칩 방식 비교. (사진=삼성전기 유튜브 캡처) |
|
기존에는 IC칩과 메인보드를 금속선으로 함께 묶는 와이어 본딩 방식을 사용했습니다. 가장 직관적이고 단순하지만 금속선이 튀어나와 공간 효율성이 낮았습니다. 다른 부품을 배치하기가 어렵다는 거죠. 신호 전송 속도도 느립니다. 전자기기가 복잡해지면서 와이어 본딩 방식은 한계에 부딪혔죠. 반면 그 대안으로 등장한 FC-BGA는 신호 전송 속도는 더 빠르고 공간 효율성도 높습니다.
FC-BGA는 다른 패키지 기판보다 더 높은 층을 쌓을 수 있는 것도 장점입니다. 층을 많이 쌓을수록 회로를 많이 확보해 고성능 반도체를 지원하기에 적합합니다. 아직 IT 불황이 계속될지라도 AI와 자율주행 시대로 인해 중장기적 성장 가능성이 크다는 데에는 이견이 없죠.
 | | (사진=이데일리 DB) |
|
FC-BGA 시장에서 두각을 드러내는 곳은 대만과 일본입니다. 대만 유니마이크론이 지난해 FC-BGA 매출액 1위를 기록했고 대만 난야와 일본의 이비덴, 신코 등이 뒤따릅니다.
국내에선 삼성전기와 LG이노텍이 FC-BGA 시장에 진출한 상황입니다. 삼성전기는 FC-BGA 사업을 강화하고자 지난 2021년부터 국내외 시설에 1조9000억원을 투자했고 LG이노텍도 지난해부터 FC-BGA 관련 시설과 설비에 약 4130억원을 투입하고 있죠.
한국 기업은 시장 최상위권 업체는 아니지만 공격적인 투자로 영향력 확대를 꾀하고 있습니다. 끊임없이 관련 기술을 개발해 FC-BGA 시장의 본격적인 개화에 대비하고 향후 수주 확보에 심혈을 기울인다는 방침입니다.
업계 관계자는 “수주산업인 FC-BGA 시장에서 우리 기업들은 점유율을 늘리기 위해 꾸준히 기술 투자를 이어갈 것”이라며 “앞선 기술력이 바탕이 돼야 향후 FC-BGA 수요가 대폭 늘어날 때에 물량을 따낼 수 있을 것”이라고 말했습니다.

.png)